直流磁控溅射的工艺参数对铝膜沉积速率的影响
直流溅射功率对Al 膜沉积速率的影响
图1为不同溅射功率下Al膜的沉积速率。实验时溅射功率的变化范围为2000~3000W,其他工艺参数相同:溅射气压为0.5Pa;靶基距80mm;Ar气流量为170sccm,基片温度为130℃。由图1可以看出,随着直流功率的增大,在2~2.4kW范围内,沉积速率几乎成线性增加,这是因为在溅射镀膜过程中,基片上的沉积速率与溅射率成正比关系。但是2.4kW之后沉积速率的增加率明显变小而随后趋于平缓。这种非线性增加的转变,可以解释为: 随着溅射Ar+离子能量的持续增大产生了“离子注入效应”的现象,这种效应使部分离子深入到晶格内部,将绝大部分的能量消耗在靶材内部而不是靶材的表面。
图1 Al薄膜沉积速率与直流溅射功率之间的关系
溅射气压对薄膜沉积速率的影响
图2 是Al薄膜沉积速率与溅射气压之间的关系曲线。实验中溅射气压的变化范围为0.3~0.9Pa,其它参数相同:溅射功率为2600W;靶基距80mm; Ar气流量为170sccm,基片温度为130℃。
从图2 看出,溅射气压从0.3Pa 增大到0.4Pa的过程中,沉积速率随之增大;在0.4Pa时,沉积速率达到一个极大值,此后沉积速率随着溅射气压的增大而下降。这种现象的产生可以解释为:
图2 Al 薄膜沉积速率与溅射气压之间的关系
由气体分子运动论可知,气体分子平均自由程与压强有如下关系:
式中λ为气体分子平均自由程,k为玻耳曼常数,T为气体温度,d为气体分子直径,p为压强。在保持气体分子直径和气体温度不变的条件下,如果工作压强增大,则气体分子平均自由程将减小,溅射原子与气体分子相互碰撞次数将增加,二次电子发射将增强。由气体放电理论可知,电流密度j0与汤生第三电离系数γ和阴极位降区厚度dc的关系为:
其中ε0是真空中的介电常数,μi是离子的迁移率,Vc是阴极位降。由上面的分析可知,压强增大时,二次电子发射将增强,那么γ就增大,同时dc将随之减小。根据式(2),当γ增大、dc减小时,电流密度j0增大,因此放电加强,溅射能力增强,沉积速率就会增大。当工作气压过大时,沉积速率会减小,原因有两点: 第一,随着Ar气分子的增多,溅射原子与Ar气分子的碰撞次数大量增加,这导致溅射原子能量在碰撞过程中大大损失,致使粒子到达基片的数量减小,沉积速率下降。第二,由于气体分子平均自由程减小,溅射原子的背散射和受气体分子散射的几率增大,而且这一影响已经超过了放电增强的影响。溅射原子经多次碰撞后会有部分逃离沉积区域,基片对溅射原子的收集效率就会减小,从而导致了沉积速率的降低。
其它高清亚洲日韩在线欧美相关的文章:







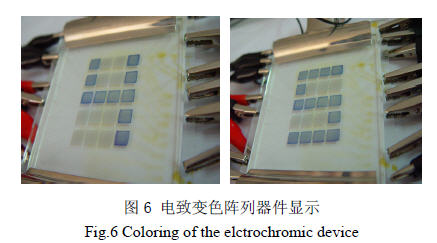
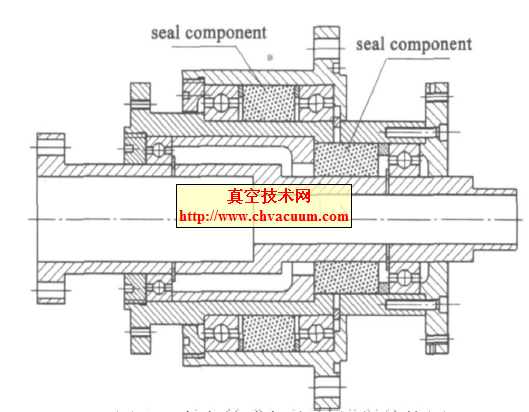





 等化合物体提升检查是否液相火成岩(PECVD)是也是借助微波rf射频或rf射频等使带有薄膜和珍珠棉
等化合物体提升检查是否液相火成岩(PECVD)是也是借助微波rf射频或rf射频等使带有薄膜和珍珠棉
 电解电容藕合方式方法是由与地面的充放电室(由pp数值比较小 的的原材料如石英晶体转化成)
电解电容藕合方式方法是由与地面的充放电室(由pp数值比较小 的的原材料如石英晶体转化成)
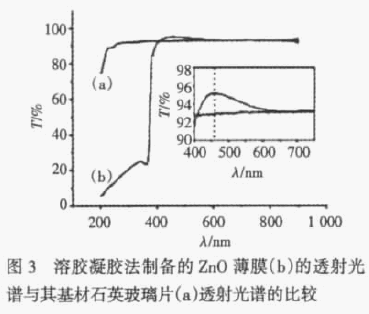 从ZnO透气膜的晶状体设备构造、微电子技术性、电学性、微电子属性、气敏属性
从ZnO透气膜的晶状体设备构造、微电子技术性、电学性、微电子属性、气敏属性
 ECR正离子源红外光动能实现红外光复制粘贴窗(由瓷质或石英砂制作而成的) 经波导或天
ECR正离子源红外光动能实现红外光复制粘贴窗(由瓷质或石英砂制作而成的) 经波导或天
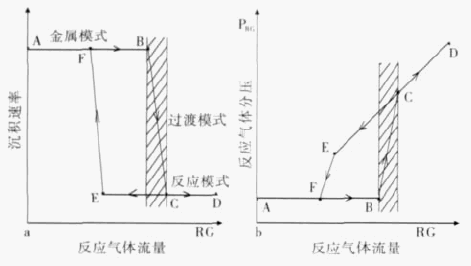 反响磁控溅射技能是沉淀积累单质塑料膜的大部分手段之1。沉淀积累创新扩散理论组成成分
反响磁控溅射技能是沉淀积累单质塑料膜的大部分手段之1。沉淀积累创新扩散理论组成成分